/index.php/article/2021/05/94
随着集成电路封装密度提高,芯片上的引脚由四周分布变为全芯片表面分布,而对应基板上的引脚也由四周分布变为全基板分布。
传统的Die bonder和Wire Bonder设备已经无法满足这种新型引脚分布的封装要求,因此倒装芯片封装技术应运而生。
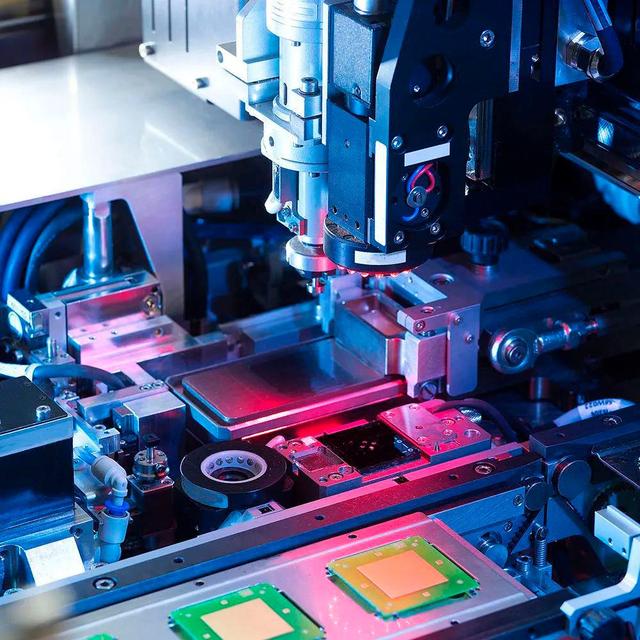
倒装芯片并不是一种特定的封装形式(如SOIC),也不是一种封装类型(如BGA) 。倒装芯片是一种无引脚结构,“倒装”指的是将晶片贴装到封装载体上的一种电气连接方式。
倒装芯片封装流程大致为:先在I/O pad上沉积锡铅球,然后将芯片翻转加热,利用熔融的锡铅球将元件与陶瓷基板贴合。
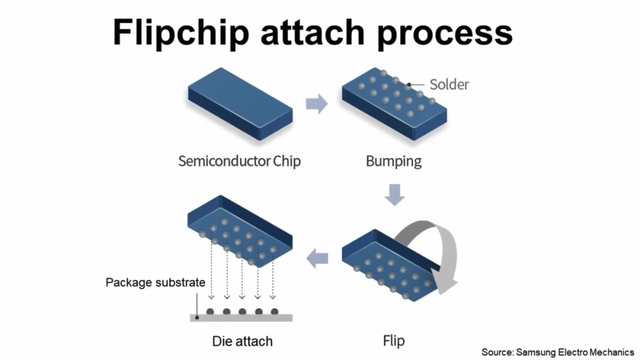
相比传统打线封装,倒装芯片具有绝对优势。
1.更多的IO接口数量
2.更好的电气性能和散热性能
3.更小的封装尺寸和更稳定的结构特性
4.不受焊盘尺寸的限制,便于批量生产
由于I/O引出端分布于整个芯片表面,倒装芯片在封装密度和处理速度上可以说已达到技术顶峰,目前已全面导入计算机、无线通信、电信/数据、硬盘磁头、智能传感器、汽车电子、消费电子和一些医用高精密设备等领域中。
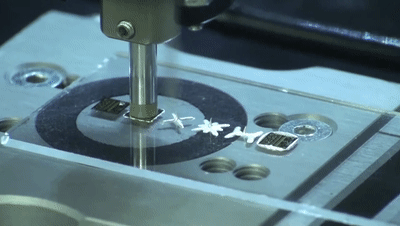
更高的封装难度,更大的行业机遇。
由于倒装芯片比BGA或CSP具有更小的外形尺寸、更小的球径和球间距,这就要求组装设备具有更高的精度。
同时,由于倒装芯片的基材是比较脆的硅,若取料过程中Flip Arm和Bond Arm交接芯片无缓冲力控,就容易发生基材压裂的情况;另外,如果助焊剂浸蘸时使用的压力过大,则容易造成焊凸变形等情况。

因此,如何在高速贴片的同时保证精密贴合、精准力控和高稳定性,一直是封装企业所关注的重点。

国奥直线旋转电机,提升设备精度及稳定性
高速度,提升贴片效率
一体化高度集成设计,尺寸仅85mm*130mm*20mm,大大降低机身体积及重量,解决Z轴自重负载问题, 运动速度大幅提升,同时节省设备内部空间,轻松实现矩阵排列;推力曲线平滑、稳定、无毛刺,可在高速运行状态下仍保证稳定输出,大幅提升生产效率。
高精度,提升贴合良率
国奥直线旋转电机力控精度可达±0.01N,直线重复定位精度达±2μm,旋转重复定位精度达±0.01°,径向偏摆小于10μm,编码器分辨率标准1μm,精度及稳定性优于市面上绝大多数品牌产品,处于全球领先水平。
软着陆,保护精密元件
对于0.3mm左右的超薄芯片,有时甚至要求设备的贴装压力控制在35g左右。国奥直线旋转电机带有软着陆功能,可实现±1.5g以内的稳定力度控制,使输出头以非常轻的压力触碰元件,降低损耗。
随着小型化高密度封装的出现,行业对高速高精度装配的要求变得更加迫切,相关的设备和工艺只有进一步升级才能满足市场需求,国奥电机助力企业在新的行业趋势下破局增效,为您的设备升级助力。